【ITBEAR科技資訊】1月18日消息,據(jù)最新研究報(bào)告披露,臺(tái)積電正在大幅提升其系統(tǒng)級(jí)集成單芯片(SoIC)的產(chǎn)能規(guī)劃。按照新的計(jì)劃,到2024年底,該公司的SoIC月產(chǎn)能將飆升至5000-6000顆,以滿足人工智能(AI)和高性能計(jì)算(HPC)領(lǐng)域的迫切需求。
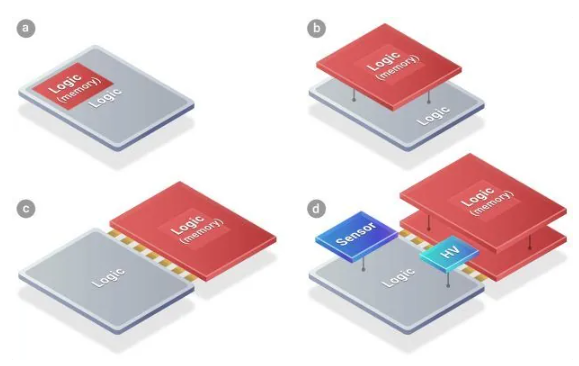
AMD作為臺(tái)積電SoIC技術(shù)的首個(gè)合作伙伴,其AI芯片新品MI300結(jié)合了SoIC和CoWoS封裝技術(shù)。如果MI300取得市場(chǎng)成功,它將成為臺(tái)積電SoIC技術(shù)的一個(gè)重要里程碑。此外,據(jù)ITBEAR科技資訊了解,臺(tái)積電的另一大客戶蘋果公司也對(duì)SoIC技術(shù)表示出濃厚興趣。蘋果正在小規(guī)模試產(chǎn)采用SoIC技術(shù)與熱塑碳纖板復(fù)合成型技術(shù)相結(jié)合的產(chǎn)品,并計(jì)劃在2025-2026年實(shí)現(xiàn)量產(chǎn),目標(biāo)應(yīng)用于Mac、iPad等設(shè)備。這種制造方案的成本優(yōu)勢(shì)相較于當(dāng)前的生產(chǎn)方式更為顯著。

業(yè)內(nèi)專家分析認(rèn)為,蘋果選擇這一技術(shù)路線是基于其產(chǎn)品設(shè)計(jì)、市場(chǎng)定位以及成本控制等多方面的綜合考慮。如果未來SoIC技術(shù)能夠成功應(yīng)用于筆記本電腦、智能手機(jī)等消費(fèi)電子產(chǎn)品,將有望進(jìn)一步激發(fā)市場(chǎng)需求,并促使更多大客戶跟進(jìn)采用。
臺(tái)積電的SoIC技術(shù)是業(yè)內(nèi)首個(gè)實(shí)現(xiàn)高密度3D chiplet堆疊的解決方案。該技術(shù)通過在芯片之間創(chuàng)建鍵合界面,實(shí)現(xiàn)了芯片的直接堆疊。在封裝技術(shù)領(lǐng)域,凸點(diǎn)間距(Bump Pitch)是衡量封裝集成度和難度的重要指標(biāo)。臺(tái)積電的3D SoIC技術(shù)的凸點(diǎn)間距最小可達(dá)到6um,領(lǐng)先于其他封裝技術(shù)。
作為一種前沿的3D封裝技術(shù),SoIC在臺(tái)積電的異構(gòu)小芯片封裝戰(zhàn)略中扮演著關(guān)鍵角色。與CoWoS和InFo技術(shù)相比,SoIC提供了更高的封裝密度和更小的鍵合間隔,并且可以與CoWoS/InFo技術(shù)相結(jié)合使用。基于SoIC的CoWoS/InFo封裝將進(jìn)一步減小芯片尺寸,實(shí)現(xiàn)多個(gè)小芯片的集成。
有消息人士透露,SoIC技術(shù)在2023年底的月產(chǎn)能預(yù)計(jì)為2000顆,原計(jì)劃是在2024年擴(kuò)大至3000-4000顆。然而,最新的產(chǎn)能規(guī)劃已經(jīng)上調(diào)至5000-6000顆,并且2025年的目標(biāo)月產(chǎn)能有望實(shí)現(xiàn)再次翻倍。與此同時(shí),經(jīng)過15年發(fā)展的CoWoS技術(shù)預(yù)計(jì)到今年年底將實(shí)現(xiàn)月產(chǎn)能30000至34000件。






