將光學(xué)光刻技術(shù)擴展到深紫外波長以外的工作始于1980年代。日本和美國的研究人員率先開展了“軟X射線”研究并展示了其可行性,此后將EUV研究推向了下一階段。
ASML自1984年后,在其他半導(dǎo)體領(lǐng)導(dǎo)者(如英特爾的EUV LLC)與AMD,臺積電,美光,摩托羅拉,英飛凌和IBM合作的推動下,ASML在2006年提供了EUV原型Alpha演示工具。
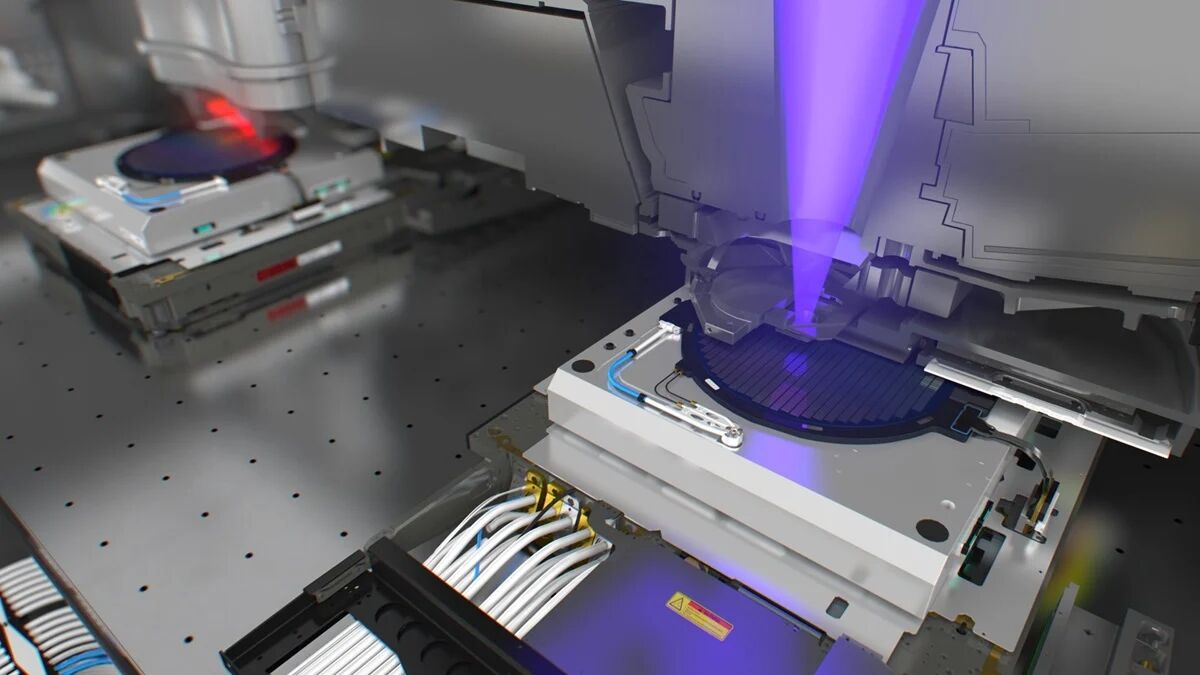
光刻機
光刻的工作原理
光刻系統(tǒng)實質(zhì)上是投影系統(tǒng)。通過將要印刷的圖案的藍圖(稱為“掩模”或“標線片”)投射光線。藍圖比芯片上的預(yù)期圖案大四倍。利用在光中編碼的圖案,系統(tǒng)的光學(xué)器件會收縮并將圖案聚焦到感光硅晶圓上。圖案打印后,系統(tǒng)會稍微移動晶圓并在晶圓上進行另一個復(fù)制。
重復(fù)該過程,直到晶片被圖案覆蓋為止,從而完成了晶片芯片的一層。為了制造整個微芯片,該過程將重復(fù)100次或更多次,將圖案放置在圖案之上。根據(jù)層的不同,要打印的特征的大小也不同,這意味著不同類型的光刻系統(tǒng)可用于不同的層。
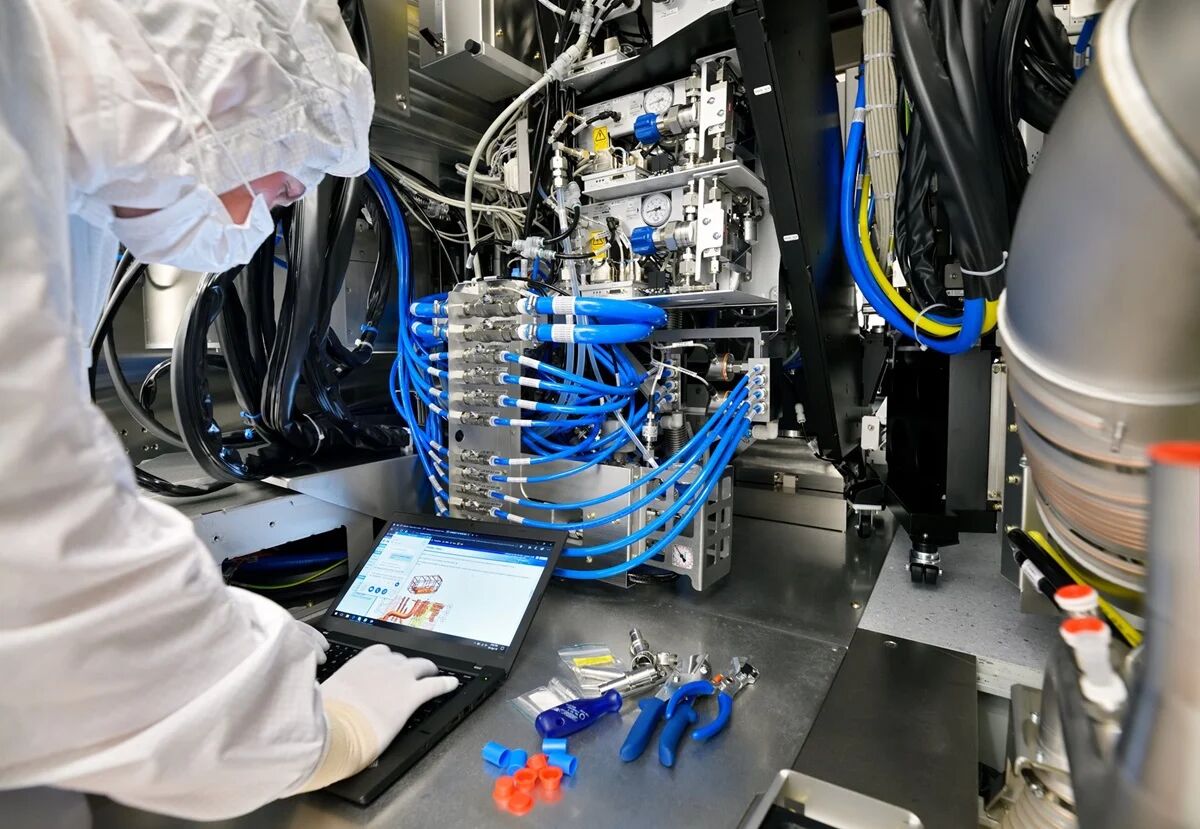
EUV光刻
ASML是世界上唯一使用極端紫外線的光刻機制造商。EUV光刻使用的波長僅為13.5納米(近乎X射線)的光,是先進芯片制造中其他使能的光刻解決方案DUV(深紫外)光刻技術(shù)(使用193納米光)的近14倍的減少,幾乎減少了14納米,EUV平臺通過提供分辨率改善,最先進的覆蓋性能和逐年降低的成本,擴展了客戶的邏輯和DRAM路線圖。
DUV光刻
ASML的DUV(深紫外線)平臺是行業(yè)的“主力軍”,提供浸沒式和干式光刻解決方案,可幫助制造各種半導(dǎo)體節(jié)點和技術(shù)。ASML的浸入式和干式系統(tǒng)在高產(chǎn)量,最先進的邏輯和存儲芯片制造方面的生產(chǎn)率,成像和覆蓋性能方面在業(yè)界處于領(lǐng)先地位。ASML的浸沒系統(tǒng)可以提供單次通過和多次通過光刻,并且已設(shè)計為與EUV光刻結(jié)合使用以印刷芯片的不同層。
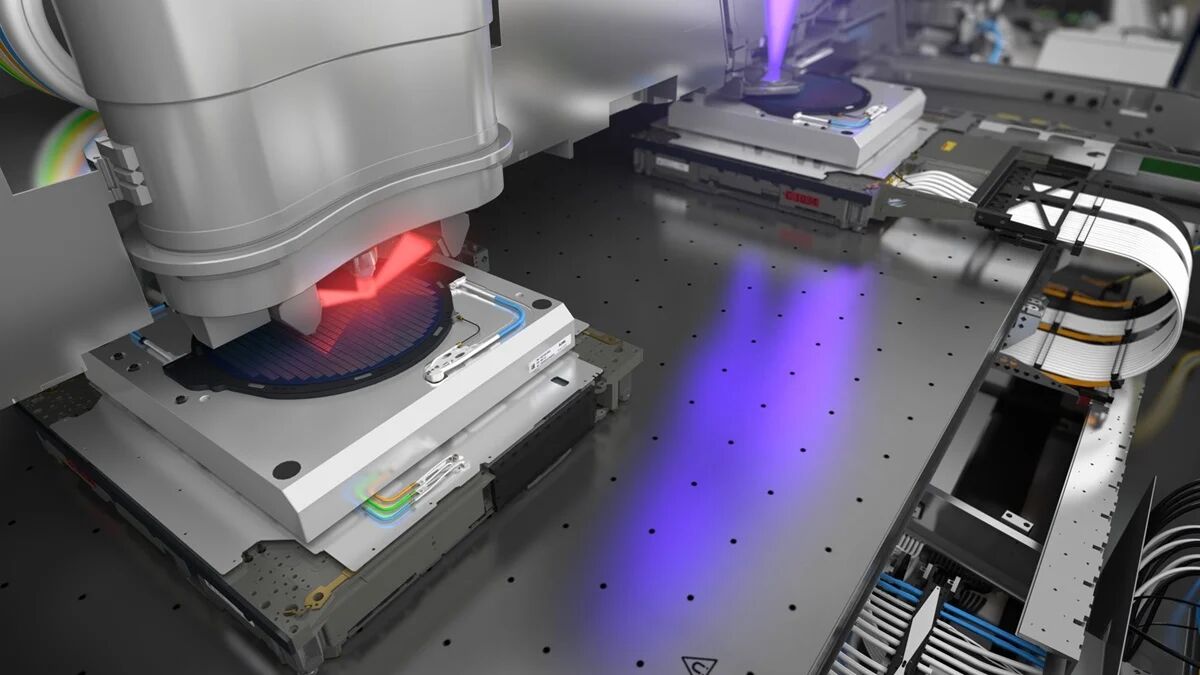
EUV光刻
芯片檢驗
ASML的計量解決方案可以快速測量硅晶片上的成像性能,并將數(shù)據(jù)實時實時反饋到光刻系統(tǒng)中,從而有助于在大批量芯片制造中保持穩(wěn)定的光刻性能。我們的檢查解決方案有助于在數(shù)十億個印刷圖案中定位和分析單個芯片缺陷。
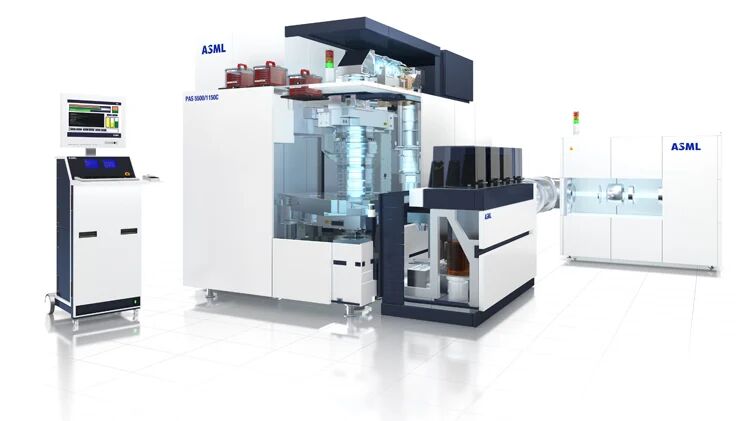
超越摩爾定律
1965年,英特爾的共同創(chuàng)始人之一戈登·摩爾預(yù)測,芯片中的晶體管數(shù)量每兩年將翻一番,從而成倍地增加了計算能力并降低了成本。摩爾的預(yù)言已被證明是正確的,或者有人認為這是一種自我實現(xiàn)的預(yù)言。如今的芯片包含數(shù)百億個晶體管。擴展摩爾定律變得越來越困難,成本越來越高。但是ASML并沒有像某些人所相信的那樣接近物理的基本極限。下一代芯片設(shè)計將包括更多奇特的材料,新的封裝技術(shù)和更復(fù)雜的3D設(shè)計。
隨著技術(shù)的進步和晶圓圖案的縮小,我們模型的精度要求也隨之提高。如今,在大批量生產(chǎn)中,我們正在將特征成像到單納米級別,并要求(對于簡單的一維特征)亞納米精度。
展望未來,計算光刻技術(shù)將繼續(xù)在改善機器成像性能方面發(fā)揮不可或缺的作用,從而使人類能夠繼續(xù)推動摩爾定律。

光刻機






